超快激光讓微孔加工效率提升 10 倍,,精度達 ±2μm
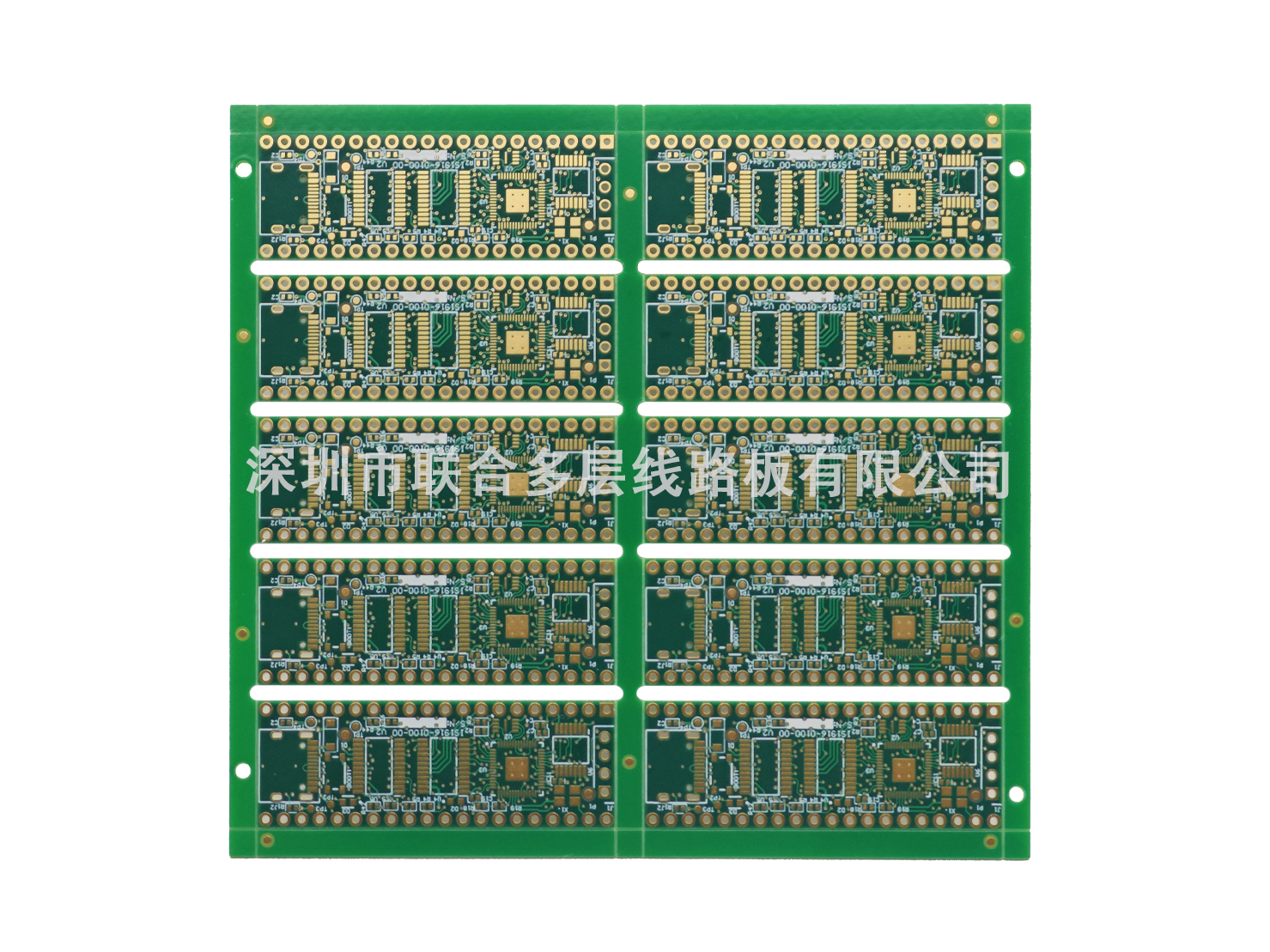 在高精度線路板制造領(lǐng)域,,超快激光加工技術(shù)的突破正在改寫行業(yè)規(guī)則。通過飛秒激光與振鏡掃描系統(tǒng)的結(jié)合,,該技術(shù)可在 PCB 上加工出直徑 10μm,、深寬比 5:1 的微孔,加工效率較傳統(tǒng)機械鉆孔提升 10 倍,,精度達 ±2μm,,為高密度互連(HDI)和先進封裝提供了關(guān)鍵支撐。
在高精度線路板制造領(lǐng)域,,超快激光加工技術(shù)的突破正在改寫行業(yè)規(guī)則。通過飛秒激光與振鏡掃描系統(tǒng)的結(jié)合,,該技術(shù)可在 PCB 上加工出直徑 10μm,、深寬比 5:1 的微孔,加工效率較傳統(tǒng)機械鉆孔提升 10 倍,,精度達 ±2μm,,為高密度互連(HDI)和先進封裝提供了關(guān)鍵支撐。
傳統(tǒng)機械鉆孔受限于鉆頭磨損和孔徑精度,,難以滿足 HDI 板的微孔需求(孔徑 < 50μm),。而超快激光利用超短脈沖(飛秒級)的高峰值功率,通過光熱效應(yīng)瞬間氣化材料,,避免了熱損傷和孔壁粗糙問題,。例如,,某 12 層 HDI 板采用激光鉆孔后,,微孔合格率從 70% 提升至 95%,信號傳輸損耗降低 20%,,滿足 BGA 封裝的高密度互連要求,。此外,激光加工無需更換鉆頭,,可連續(xù)加工不同尺寸的微孔,,大幅提升生產(chǎn)效率。
工藝創(chuàng)新進一步拓展了技術(shù)應(yīng)用場景,。激光直接成像(LDI)技術(shù)配合超薄干膜,,可將線路側(cè)壁垂直度提升至 88° 以上,減少高頻信號的邊緣輻射損耗,;激光切割技術(shù)則替代傳統(tǒng)銑刀,,實現(xiàn) PCB 外形的無應(yīng)力加工,避免板材變形,。在先進封裝領(lǐng)域,,激光加工可用于硅通孔(TSV)和微凸塊制造,支持芯片三維集成,,推動半導(dǎo)體封裝向更高密度發(fā)展,。
隨著技術(shù)的成熟,超快激光加工正從高效 HDI 板向普通多層板普及,。某企業(yè)引入激光加工設(shè)備后,,將微孔加工成本降低 40%,,同時縮短了產(chǎn)品交付周期。未來,,激光技術(shù)將與 AI 視覺檢測系統(tǒng)結(jié)合,,實現(xiàn)加工過程的實時質(zhì)量監(jiān)控與反饋,進一步提升加工精度與穩(wěn)定性,。預(yù)計到 2027 年,,全球激光加工設(shè)備在 PCB 行業(yè)的滲透率將超過 30%,成為智能制造的重點裝備之一,。

